コベルコ科研のウェハレベル評価メニュー
【ウェハ形状計測】
-
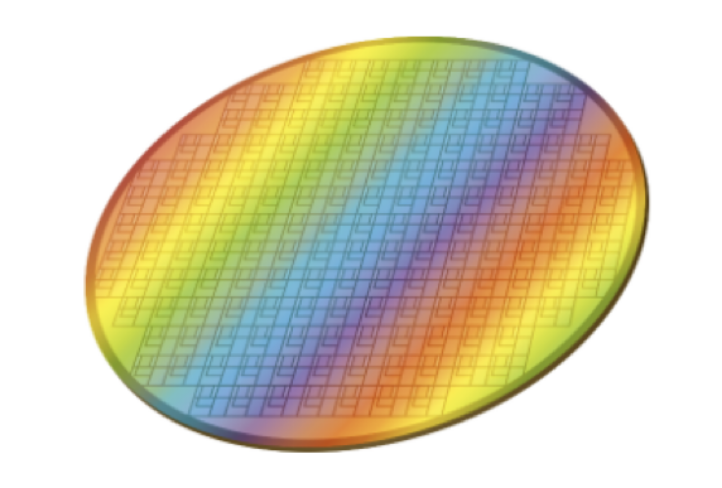 半導体デバイスは、スマートフォン、パソコンから自動車、家電製品、産業用機械などあらゆる機器に内蔵され、今日の社会に必要不可欠な重要な部品であることから、その需要は年を追って伸び続けています。
半導体デバイスは、スマートフォン、パソコンから自動車、家電製品、産業用機械などあらゆる機器に内蔵され、今日の社会に必要不可欠な重要な部品であることから、その需要は年を追って伸び続けています。
この半導体素子は、Si、SiCなどに代表される単結晶基板上に極微細加工によりデバイスを形成し製造されます。このスタートとなる基板の品質は、半導体デバイス自体の品質、歩留まりに大きく影響することから、その非破壊での検査・計測がますます重要になっています。コベルコ科研は、半導体基板(ウェハ)の検査装置で長年の実績を誇っており、それらを利用した高度な分析・解析で半導体デバイスに関わる産業・社会の様々な問題解決に貢献しています。
-
ウェハ形状計測
(Bow/Warp/
GBIR(TTV))Siウェハ、パワー半導体用基板、ガラス基板などのたわみ、反り形状、厚み分布などの計測を行います。
ウェハサイズは12インチまで可能で、自重の影響に依る変形を補正致します。
最近では、積層デバイスなど、ウェハの薄肉化、貼り合わせなど工程が多様化しており、各工程におけるウェハの変形のモニタリングに活用されています。
ウェハのBow、 Warp、 GBIR(TTV) - 特徴
-
- ・独自の自重補正法採用、重力影響のないたわみ・反り形状を算出
- ・レーザー変位計により、高抵抗・絶縁性基板にも対応
- ・Bow、Warpは3点基準の測定値と最小二乗(best fit)平面基準の測定値を算出
評価装置(LTVデモ機)仕様 ウェハサイズ 4~12インチ 厚さ 600~1400μm 測定位置 R:最小1mmピッチ
Θ:標準8ライン
(最大16ライン)計測方式 レーザー変位計 シリコン、ガラス、ワイドギャップ半導体基板などにおいて、薄膜形成、研磨、貼り合せ加工などによる反りの変化や厚さばらつきを評価できます
事例1:ウェハ形状計測の評価例
ウェハ形状測定の出力事例です。二次元、三次元のマップや断面プロファイルなど種々の出力で変形挙動をビジュアル化致します。エッジ形状、サイトフラットネス、魔境測定なども実施しておりますので、別途、ご相談下さい。
- 条件により以下のものも評価可能
-
- ・ガラス/セラミック、ワイドギャップ半導体など各種材料の加工後、形状評価
- ・貼り合せ加工後、形状評価
- ・薄膜形成、再配線加工などによるウェハ反り形状の評価


- お問い合わせ
-
上記に関するお困りごとやご相談がございましたら、
お問い合わせフォームよりお気軽にお問い合わせ下さい。 - お問い合わせフォーム
