コベルコ科研・技術ノート
こべるにくす
Vol.33
No.61
- TOP
- 技術ノート「こべるにくす」一覧
- アーカイブス
- 高分解能RBS/ERDAによる半導体材料表面の結晶性および組成分布評価
Technical
Report
C
高分解能RBS/ERDAによる
半導体材料表面の結晶性および組成分布評価
イオンビームをプローブとした分析手法の中で、ラザフォード後方散乱法(RBS:Rutherford backscattering spectroscopy)は、物質の表面から数μm程度の領域の元素組成分布や原子配列の決定に広くもちいられてきた。特に半導体デバイスの薄膜の組成分布、注入イオン分布やこれに付随する結晶性の評価、および金属/半導体界面反応などの分析に威力を発揮している1)。一般的なRBSは1~2MeV程度のHeイオンを試料に照射して、散乱したイオンのエネルギースペクトルを取得する測定手法であり、10nm程度の深さ分解能で定量性の良い元素分析をおこなうことができる。しかしながら、近年、半導体デバイスの微細化とともに極薄膜化が進んでおり、サブnmの深さ分解能が要求されるようになってきている。そのため従来のRBSでは深さ分解能が不十分となっていた。この課題に対して当社では、(株)神戸製鋼所と京都大学によって開発された高分解能RBS装置を導入し、最高0.2nmの深さ分解能で極薄膜の組成分布や表面近傍の結晶性を評価してきた2)。また、入射イオンによって反跳されたイオンをエネルギー分析する弾性反跳法(ERDA:Elastic recoil detection analysis)を組み合わせることで、検出の難しいHの分布も決定することができるため、最表面におけるより詳細な極薄膜の組成分布評価が可能である。
本稿では半導体材料を題材に、高分解能RBS/ERDA(HR-RBS/HR- ERDA)によりイオン注入をおこなった単結晶基板の注入イオン分布および結晶性を評価した事例と、極薄膜の組成分布を評価した事例、さらに加熱しながらの高分解能ERDA(加熱HR-ERDA)によりHを測定する新たに開発した分析技術を紹介する。
C-1 Asイオン注入によるSi基板表面の結晶性およびAsイオン分布の評価
HR-RBSでは、結晶軸に沿ってイオンを入射するチャネリング法をもちいることで、単結晶表面付近の原子配列の乱れや注入イオンの分布を詳細に決定することができる。第1図にSi(100)表面に対してランダムな方向と[110]軸方向から見た場合の原子配列を示す。Heイオンをランダム方向から入射した場合、深部のSi原子からも散乱されるため、スペクトルでは低エネルギー側に幅を持ったブロードなピークとして検出される。一方、結晶軸に沿ってHeイオンを入射すると、表面のSi原子が背後のSi原子を隠すため、深部のSi原子からの散乱確率が減少する。そのため、スペクトルでは深部からの散乱成分に対応する低エネルギー側の強度が減少し、シャープなピークとして検出されることとなる。この散乱確率の減少は原子配列が揃っているほど大きくなるため、散乱確率の減少の程度から単結晶試料について深さ方向の結晶性の評価が可能となる。本章では、Asイオンを注入したSi基板に対する注入エネルギーや注入後の加熱処理温度によるAsの分布およびSi基板の結晶性の変化を評価した事例を紹介する。
第1図 入射方向別のSiの原子配列とHR-RBSスペクトル

第2図 注入エネルギーを変えた場合のHR-RBSスペクトル

第1表
Asイオン注入による
Siの原子配列が乱れている厚さの解析結果

第3図 Asイオン注入後に加熱処理した場合のHR-RBSスペクトル

第2図は1×1015 atoms/cm2相当のAsイオンをそれぞれ1keV、3keV、5keVのエネルギーで注入したSi(100)単結晶基板をチャネリング法によって測定したHR-RBSスペクトルを示している。スペクトルの各ピークは、高エネルギー側からそれぞれAs、Si、Oからの散乱成分に対応する。Asピークに着目すると、1keVで注入した試料では、280keV付近にシャープなピークとして検出されている。一方、注入エネルギーの増加にともないピーク位置が低エネルギー側へシフトし、スペクトル形状も徐々にブロードな形状に変化する傾向が認められる。試料深部からの散乱成分がピークの低エネルギー側に対応することから、注入エネルギーが1keVの場合では試料表面付近にAsが分布しているのに対して、注入エネルギーが増加すると試料深部にまでAsが分布していることがわかる。次にSi基板の結晶性を評価するためSiピークに注目する。注入エネルギーが1keVの場合では、主に表面付近のSiからの散乱によるシャープなピーク形状であるのに対し、注入エネルギーの増加にともない試料深部からの散乱成分が増加し、低エネルギー側に幅を持った形状へ変化している。各スペクトルは同じ結晶軸にHeイオンを入射しており、原子配列が同じであるため、このスペクトルの変化から注入エネルギーの増加にともないSiの原子配列の乱れが深部にまで広がっていくことがわかる。第1表にSiの原子配列が乱れている厚さを解析した結果を示す。注入エネルギーの増加にともない原子配列の乱れている領域が増加しており、スペクトル形状の変化と対応した結果となっている。
次に1×1015 atoms/cm2相当のAsイオンを注入したSi基板に加熱処理をおこなったときのAsイオン分布と結晶性の変化を分析した。第3図にAsイオンを3keVのエネルギーで注入したSi(100)単結晶基板に対して、それぞれ600℃、700℃、900℃で加熱処理をおこなった試料のHR-RBSスペクトルを示す。加熱処理温度が上昇するにしたがって、Asピークは高エネルギー側へシフトしシャープなピーク形状へ変化している。またSiピークにおいても、加熱処理温度の上昇にともない低エネルギー側の散乱成分が減少する傾向が認められる。これらの各ピークの形状変化から、加熱処理の温度が上昇するとAsが表面側へ移動し、Si基板の表面付近の原子配列の乱れが回復していることがわかる。
このようにHR-RBS分析から単結晶基板の表面近傍の結晶性や注入イオンの深さ分布の変化を詳細に把握することが可能である。
C-2 HR-RBS/HR-ERDAによるHfSiO2膜の組成分布評価
CMOSトランジスタのゲート絶縁膜に使用されるHigh-k膜の特性は、膜の組成や深さ方向分布が大きく影響を及ぼす。近年の極薄膜化の進展によってこれらの分析には高い深さ分解能が求められているが、このような極薄膜試料の組成分布評価に対してもHR-RBS/HR-ERDAは有効な手法として威力を発揮する。そこで本章では極薄膜のHfSiO2膜を題材として、加熱処理による組成分布の変化をHR-RBS/HR-ERDAで分析した事例を紹介する。
第4図 加熱処理前後のHfSiO2膜のHR-RBSスペクトルおよびHR-ERDAスペクトル
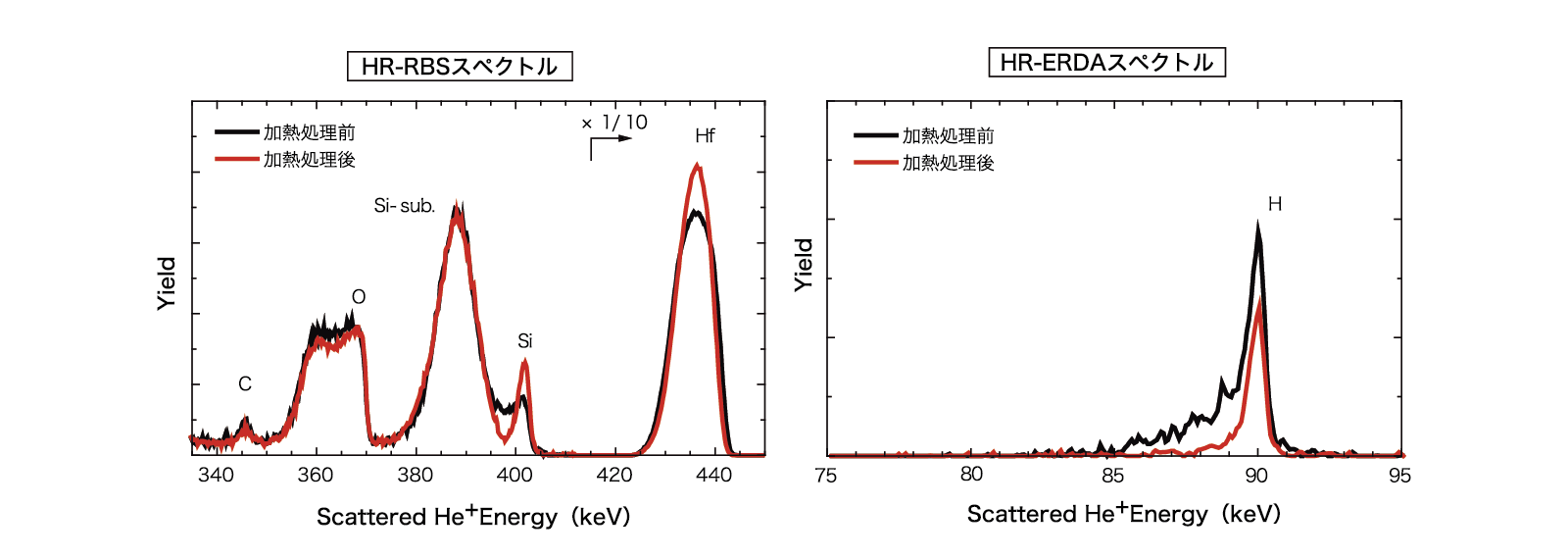
第4図にHfSiO2(膜厚:2nm)/SiO2(膜厚:1nm)/Si基板の加熱処理前と加熱処理後のHR-RBSおよびHR-ERDAスペクトルを示す。HR-RBSスペクトルの各ピークは高エネルギー側からそれぞれHf、Si、O、Cから散乱された成分に対応する。また、Siピークのうち高エネルギー側のピークはHfSiO2膜中のSiからの散乱成分であり、低エネルギー側のピークは基板のSiからの散乱成分である。Hfピークと膜中のSiピークに注目すると、各ピークのスペクトル形状が加熱処理後ではシャープな形状へ変化しており、加熱処理によって主にHfとSiの組成分布が変化していることが示唆される。
次にHR-ERDAスペクトルに着目する。HR-ERDAスペクトルもHR-RBSスペクトルと同様に、低エネルギー側の成分は試料深部から反跳されたHイオンに対応している。加熱処理前後のスペクトルともに90keV付近にシャープなピークが検出されている。このピーク位置は試料最表面からの反跳成分であり、大気搬送によって付着した水分や有機汚染物由来の成分と同定することができる。表面ピークの低エネルギー側の領域に注目すると、加熱処理前の試料では低エネルギー側に向かってなだらかに強度が減少しているのに対し、加熱処理後の試料ではほとんど検出されていない。この結果から、加熱処理によって膜中のHが減少していることがわかる。得られたHR-RBS/HR-ERDAスペクトルの解析によって算出した加熱処理前後の深さ方向組成分布を第5図に示す。加熱処理前では膜中のHfとSiの分布がブロードであり、膜全体に分散しているのに対して、加熱処理後では表面側からSi、Hfの順で二層の酸化物層が形成されているような分布へ変化している。またHの分布に着目すると、加熱処理前では膜中の深部までHが分布しているが、加熱処理によって膜中のHが大幅に減少しているのがわかる。
以上のように、数nm程度の極薄膜試料であっても、HR-RBS/HR-ERDAをもちいることでHの分布も併せて詳細に組成分布の変化を分析することが可能である。
第5図 HfSiO2膜の加熱処理前後の深さ方向組成分布

C-3 加熱HR-ERDAによる試料最表面のHの定量評価
近年、半導体技術の高機能化にともないシリコンCMOSデバイスの微細化が進められており、3次元的に縦方向にデバイスを接続する3次元集積実装技術が注目されている。積層構造の形成工程ではウエハ同士を貼り合わせる必要があり、この密着性がデバイスの性能に大きく依存する。ウエハ同士の密着性には各接合面に形成されたOH基が強く寄与していることが知られており、ウエハ最表面に存在しているOH基の定量技術が求められている。表面OH基の検出手法として、OH基に対して選択的化学修飾をおこなった後にX線光電子分光法(XPS)や飛行時間型二次イオン質量分析法(TOF-SIMS)をおこなう方法が候補として挙げられるが、これらはいずれも定量性が低い。一方、HR-ERDAは定量性に優れているという特徴を有しているため、最表面のOH基の定量に対して有力な分析手法として期待できる。しかし、試料を大気環境下に晒すと表面に有機汚染物や水分が付着してしまい、これら吸着物由来のHもHR-ERDA分析では検出されてしまう。そのため、有機汚染物由来のHと試料表面に本来存在しているH(-OH)の分離ができないことが最大の課題となっている。
一方、真空中で200℃に試料を加熱すると物理吸着した有機汚染物や水分が除去されることが報告されており3)、そのような状態でHR-ERDA測定をおこなうことができれば最表面に本来存在しているHの定量が可能となる。そこで、既存の高分解能RBS装置に加熱機構を取り付け、真空中で加熱しながらHR-ERDA分析を行う手法を開発した。フッ酸処理をおこなったSi基板を室温環境下で測定した場合と200℃で加熱しながら測定した場合のHR-ERDAスペクトルを第6図に示す。その結果から、200℃で加熱しながら測定したスペクトルの強度が室温環境下で測定したときより減少しているのがわかる。また、試料の加熱温度を変化させたときのH量を調べてみると、加熱温度が150℃までは表面のH量に変化がみられないが、200℃に温度を上昇させると表面H量が減少する傾向が認められる。この傾向は先行研究3)の報告とも一致していることから、本手法によって表面に吸着した有機汚染物や吸着水の影響が抑制されていることがわかる。現在も継続して加熱HR-ERDA分析の高度化を進めているが、先行して室温から200℃までの任意の温度での加熱HR-ERDA分析をメニュー化している。
第6図 加熱HR-ERDA分析結果の例

本稿では半導体材料を題材として、HR-RBS/HR-ERDAによる極薄膜の組成分布や表面近傍の結晶性、および注入イオン分布をサブnmの深さ分解能で定量性よく評価できることを紹介した。また、新たに開発した加熱HR-ERDA分析が最表面のHの定量に有効な手法であることを示した。近年、SiCやGaNなどの次世代パワー半導体の開発も活発に行われており、これらの材料評価としてもHR-RBS/HR-ERDAは威力を発揮すると考えられる。今後ますます半導体デバイスの開発が加速することが予想される中、さらなる技術の高度化に取り組み、エレクトロニクス業界の発展に貢献する所存である。
参考文献
- *1) D. S. Germell: Rev. Mod. Phys., Vol. 46(1974), p. 129.
- *2) 森芳一ほか: R&D神戸製鋼技報, Vol. 52(2002)No.2, p. 53.
- *3) Y. Yamamoto et. al.: J. Non-Cryst. Solids., Vol. 499(2018), p. 408.
